【概要】
ガス濃度モニタ/コントローラの背景
半導体プロセスでは,多様化するデバイスに対して,微細化や多層化技術を駆使して生産が行われている。これらのプロセスでは多くの液体/固体材料が用いられており,効率よく安定的に気化供給できるシステムに対する重要性が増している。特に,現在でも幅広く利用されているバブリング方式による気化供給システムにおいて,発生した材料ガス濃度を計測・制御することが必要とされている。弊社のガス濃度モニタ(IR-300/400シリーズ)は、プロセス中の濃度モニタリング、更にはプロセス後のエンドポイントモニタリングを行うことも可能であり、現在ガス濃度モニタ/コントローラの必要とされる用途は多岐にわたっている。
【測定原理】
赤外線ガス分析法の代表的な手法としてFTIR(Fourier Transform Infrared)とNDIR(Non Dispersive Infrared)がある。特定の成分だけを測定する場合,NDIRはFTIRと比べて小型で安価な装置構成を実現できる。Figure1 に一般的なNDIRの構成を示す。赤外光源から放射された赤外光はセル窓,試料ガス,光学フィルタを透過し,赤外線検出器へ入射される。サンプル側の光学フィルタは試料ガスが吸収する波長と同じ波長の赤外光を,またリファレンス側の光学フィルタは試料ガスが吸収しない波長を透過するように設計されている。
NDIRではサンプルとリファレンスの2つの光量を比較演算することによって,光源劣化や窓汚れによる光量変化の影響を最小限にしてガス濃度を算出している。
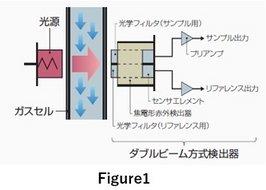

【バブリング方式における材料ガス濃度制御システム】
続いて、バブリング方式とガス濃度コントローラを組み合わせた新しい気化供給システムについて紹介する(Figure2)。バブリング方式は構造が単純で安価なシステムが構築できるという利点があるが,制御因子が多く,定量安定性に課題がある。バブラー上流側にはキャリアガス流量を制御するためのMFC,バブラー下流側にガス濃度モニタとコントロールバルブがこの順で配置された濃度コントローラ(VCC:Vapor Concentration Controller)を設置する。このシステムでは常に濃度モニタがバブラーから発生した材料ガス濃度を測定しており,予め定めた設定濃度となるようにコントロールバルブの開度を調整し,バブラー内の全圧を制御する。バブラー温度が変化し,材料ガス濃度が変化したとしても,その変動とは関係なく一定のガス濃度を供給することができる。例えば,測定濃度が設定濃度よりも高い場合,から全圧を大きくすることで濃度を下げ,逆に測定濃度が設定濃度よりも低い場合は全圧を小さくすることで濃度を上げるようにコントロールバルブを制御する。
濃度が一定に保たれている状態において,バブラー上流側に設置されたMFCによりキャリアガス流量を一定に制御すれば,材料ガス流量と混合ガス流量(全流量)も一定にすることができる。これは本システムが材料ガス濃度とキャリアガス流量という2つの制御対象量をMFCとVCCにより,それぞれ独立した制御を実現しているからである。
今後,半導体製造プロセス技術が適用される産業は益々拡大していくと思われ、本システムは,その発展の一翼を担っていくと期待している。
