

異物検出・除去を1台で完結、半導体製造プロセスの効率化・歩留まり向上を徹底追求
半導体製造の露光工程に欠かせない異物検査装置の「PD」シリーズは、1984年の発売以来、お客様のニーズに応えながら進化を続け、今年で40年の節目を迎えました。
新製品「PD Xpadion EX」には、好評をいただいている従来機「PD Xpadion」をベースに異物除去機能を搭載し、検出から除去まで1台で完結することが可能となりました。さらに、レティクル/マスクの自動搬送に対応するユニットを自社開発し、半導体製造プロセスの効率化と歩留まり向上に貢献します。
半導体産業における分析・計測・制御ニーズは、これまでにないスピードで高度化・多様化しています。「PD Xpadion EX」は、異物の成分分析やペリクル※1の膜厚測定などもワンストップで行うことのできる機能拡張に取り組んでおり、今後も新たな可能性を提示してまいります。
1.異物検出・除去工程の一体化により、作業効率・歩留まりを向上
95%以上の異物除去率※2を誇る当社のレティクル/マスク自動異物除去装置「RP-1」の機能を「PD Xpadion」と一体化。異物の検出から除去まで自動で行うことを可能としました。また、レティクル/マスクが格納されたケースを2式同時にセットできるマルチポートも備えており、連続的に異物検出・除去を行うことができます。
2.自動搬送装置との連携により、製造プロセスの自動化・省人化を促進
半導体製造工場内のOHT(Overhead Hoist Transport:搬送物を吊り下げた状態で保持し、天井に設置された軌道レールを走行する自動搬送装置)との連携に必要とされるEFEM(Equipment Front End Module:レティクル/マスクをOHTと異物検査装置の間で受け渡すユニット)を自社開発しました。お客様が求める仕様へ柔軟に対応し、生産性向上や人手不足の解消、製造エリアのスリム化を図るために重要とされる自動化・省人化に貢献します。
※1 レティクル/マスクのパターン面への異物付着を防ぐための防塵膜
※2 ガラス面に5μmのガラスビーズが付着した状態での社内テストによる結果。使用方法や条件によって効果が異なる場合があります。
事業セグメント: 半導体
製品分類: Metrology
製造会社: HORIBA, Ltd.
PD Xpadion
PD Xpadionは、光学/ステージ設計、さらに基幹ソフトウェアを含む全てのプラットフォームを一新。
高い稼働率と長期安定性はそのままに、操作性を大幅に向上しました。信頼性の高い光学系による「スキャン」、新規機能を加えた「レビュー」、革新的なセンサーとの組合せによる「アナライシス」といったオートメーションへの拡張機能を強化し Smart Factory対応を実現します。
特長
事業セグメント: 半導体
製品分類: Metrology
製造会社: HORIBA, Ltd.
レティクル・マスクの各面、又はウェハ表面に付着した異物をCDA 又は N2ブローと真空吸引で自動除去が可能。除去した異物の再付着を防ぎます。
ランニングコストの低減
日常的な異物除去作業により、マスクの洗浄サイクル、ペリクルの交換サイクルを伸ばし、ランニングコスト低減に貢献します。異物検査装置:PD Xpadionと組合わせることで、より効率的なレティクル・ウェハ管理が可能です。
特長:
人為的ペリクル破損の防止
静電破壊防止
マスク洗浄周期を延ばしコスト削減に寄与
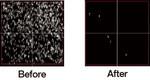
ガラス表面の5.0μm粒子を除去したテストデータ
事業セグメント: 半導体
製品分類: Metrology
製造会社: HORIBA, Ltd.
RP-1
薬液濃度モニタ
高速応答でコンパクトな薬液濃度計。使いやすく高度な薬液濃度モニタにより、レチクル/マスク洗浄中のプロセスドリフトを回避します。
マスク洗浄工程での洗浄液濃度をリアルタイムで測定し、プロセスの最適条件を維持・監視することができます。
薬液濃度モニタ
CS-100シリーズ
光ファイバ式
薬液濃度モニタ
CS-600F
非接触型
薬液濃度モニタ
CS-900
TMAH濃度モニタ
HE-960H-TM
低濃度HF/HCl/NH3
濃度モニタ
HF-960M
エンドポイント検出
独自のアルゴリズムを用いてプラズマ発光を解析し、マスクエッチング工程でのエッチングプロセスの終点を検出します。
プラズマ発光分析
エンドポイントモニタ
EV-140C
324 秒後の終点
Cr/ 石英インターフェイスに到達
マスク表面からのレーザー反射光の干渉信号を検知することにより、マスクエッチング工程でのエッチング終点を検出します。
レーザー干渉計
LEM Camera
ガス流量管理
マスクエッチング工程でのプロセスガスを制御するために、接ガス部をオールメタル構造にしたマスフローコントローラ。腐食性ガスに対する高い耐久性とデジタル通信制御を実現します。
デジタルマスフロー
コントローラ
SEC-Z500X
ガス制御
マスクストッカーのパージラインでのガス制御に最適なマスフローコントローラ。コストパフォーマンスに優れ、デジタル通信制御が可能です。
マスフロー
コントローラ
SEC-E500
デジタルマスフロー
コントローラ
SEC-N100
ペリクルの厚さ測定
次世代ペリクルの厚さ、均一性の評価に最適です。
エリプソメータ
UVISEL Plus
異物同定
レチクル・ペリクル上の異物成分を分析。
AFM機能も搭載し、多彩な機能で異物分析をサポートします。
ラマン顕微鏡
XploRA Nano




















