POINT 1: Dual-Action Blowing and Vacuum Suction Prevents Particle Re-attachment
By removing particles with an air blow while applying vacuum suction at the same time, the system effectively prevents particles from re-attaching to the pellicle surface.

POINT 2: Removes Particles from Both Sides at Once— 1-Minute Processing Time
Because particles on both the top and bottom surfaces can be removed in a single operation, processing time is significantly reduced. With a high throughput of approximately one minute per piece, overall work efficiency is dramatically improved.
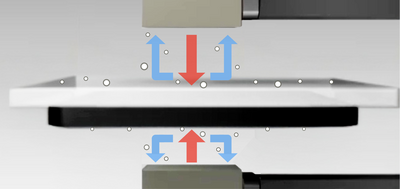
POINT 3: Automation Balances Reduced Engineer Workload with Protection for Masks and Pellicles
Automation reduces the burden on engineers while also protecting masks and pellicles. It lowers the risk of contact and damage associated with manual work (e.g., manual blowing). By minimizing human handling, the system suppresses electrostatic charging and helps reduce the risk of electrostatic discharge (ESD) damage.


POINT 4: Seamless Continuous Processing by Linking with a Particle Detection System
When combined with the particle detection system PD10, particle removal and reticle inspection can be performed seamlessly as a continuous process, enabling efficient quality control.
We also offer the integrated particle detection system PD10-EX, which completes both particle detection and removal within a single unit.
Notes
* Adhered particles may become more difficult to remove over time. Regular particle removal as part of the mask manufacturing process is recommended.