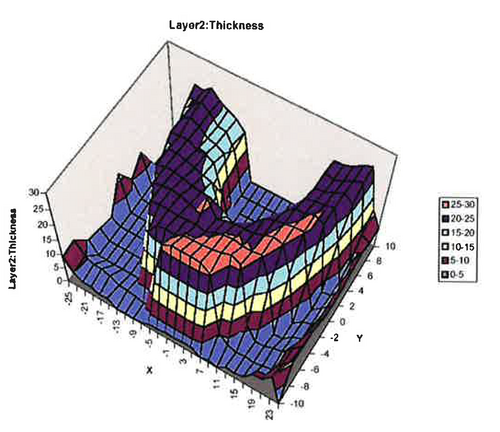
UVISEL Specifications
- Spectral range: from 190 to 885 nm │NIR extension option up to 2100 nm
- Detection: High resolution monochromator coupled to sensitive detectors
Manual Configuration
- Spot size: 0.05 – 0.1 – 1 mm (pinhole)
- Sample stage: 150 mm, manual height (20mm) and tilt adjustment
- Goniometer: Manually adjustable angle from 55° to 90° by step of 5°
Automatic Configuration
- Automation sample stage: 200x200mm, 300x300 mm XY sample stage, manual height (4mm) and tilt adjustment, XYZ sample stage, theta stage
- Automatic goniometer: Automatically adjustable angle from 45° to 90° by step of 0.01°
Integrated Goniometer
- Manual angle of incidence: 35° to 90° by 5° step
- Sample holder: 150mm, 20mm manual z height adjustment
- Autocollimation system for sample alignment in option
- Dimension: width: 25cm; height: 35cm; depth: 21 cm
In situ configuration
- Mechanical adaptation: CF35 or KF40 flanges
- Easy swith between in-situ and ex-situ configurations
- More information
Options
- Accessories: temperature controlled cell, liquid cell, electrochemical cell, reflectometry module to measure reflectance at 0° incidence, and more
- Vision: CCD camera
- More information
Performance
- Accuracy: Ψ= 45°±0.01° and Δ=0°±0.01° measured in straight-through air configuration1.5 – 5.3 eV
- Repeatability: NIST 1000Å SiO2/Si (190-2100 nm): d ± 0.1 % – n(632.8nm) ± 0.0001