Principle | Polarized laser scattering method |
Inspection object | Reticle/mask with or without pellicle |
Detector | Photomultiplier |
Light source | Argon laser 488 nm, 10 mW |
Reticle/mask size | 5" x 5", 6" x 6", 2.3 to 6.3 mm thickness (maximum 1/4") |
Pellicle | Thickness: 0.865 to 2.85 µm (±0.2 µm) Frame height: |
Detectable particle size | Pattern surface: 0.35 µm or larger |
Detectability | Standard mode: More than 90% of 0.35 µm particles. |
Particle level setting | Pattern surface: 0.25 to 10 (3 steps) |
Inspection time | Approx. 7 min from inspection start (switch ON) to map display for two-surface inspection. |
Inspection area | Shape: Square, rectangle, circle Area: |
Inspection result | LCD display: |
Particle observation | LCD screen observed from top and bottom side. |
Standard function | Automatic review (skip) function, Coordinate origin setting/rotation compensation function, Inspection center function, Map display insert/delete function, Bar code ready (Hard ware option) |
Optional functions | Pellicle only inspection, Mask blank inspection, Inspection of additional substrate size, 2 way data communication (GEM or SECS2) |
Dimensions | 1710 (W) x 1540 (H) x 1400* (D) mm |
Weight | Approx. 1000kg/2222 lbs |
| |
UTILITIES | |
Installation site | Clean bench: Class 10 or better |
Power | 200/210/220/240 V AC ±10 V (Customer specified), single phase 4k VA, 50/60 Hz |
Vacuum source | Pressure difference: 8.0 x 104 Pa or more 50 L/min. |
Reticle/Mask Particle Detection System, PR-PD2
높은 수율로 효율적인 이물 검사•측정을 실현.
높은 가동률과 안정성 등, 수많은 고성능•고기능으로 많은 반도체 제조 현장에서 높게 평가되고 있는 HORIBA의 Reticle/Mask 이물 검사 장치 PD시리즈 입니다. 긴시간 안정적으로 가동되는 반송계와 고수율과 고성능 기능을 한층 더 독자적으로 개발한 신호 처리 방식에 의해 Pr-PD 시리즈중 최고 감도로 최소 0.35μm의 미세 이물 검출을 가능하게 한 것이, 이 Reticle/Mask 이물 검사 장치 PR-PD2입니다.
• 패턴상에서 0.35μm의 이물질 검출 감도와 90%의 검출율을 자랑합니다. (적산 모드 사용에 의한 감도는 93% 입니다.)
• Reticle/Mask상의 이물 검출은 물론, 패턴/유리/페리클 각면을 높은 수율로 측정합니다.
• 고배율 Camera(배율 조정 가능)를 장착하여, 상면, 하면의 이물질을 관찰이 가능합니다.
• 각종 스텝퍼 케이스에 대응이 가능하며, 옵션으로 최대 10단까지의 다단 케이스도 대응이 가능합니다.
• 다양한 검사 조건 설정이 가능하며, 조작도 간단합니다.
• 데이터 관리 기능을 내장하여, 필요한 형식으로의 리포트 출력이 가능합니다.
사용환경
패턴의 상면을 최소 0.35μm의 미세 이물을 검출합니다.
Reticle/Mask의 회로 선폭 1.0μm까지, 라인간 1.0μm의 패턴 판별 기능에 의해, 검출 오차를 최소한으로 줄 일 수 있습니다.
용도
■ 레티클/마스크 제조 공정
마스크/레티클 Blank상의 이물 검사·측정.
EB에서 Lighting·세정 후의 패턴/유리면의 이물 검사·측정.
페리클 첨부후의 패턴/유리/페리클 각면의 이물 검사·측정.
첨부전의 페리클의 이물 측정(옵션 기능).
■노광 공정
레티클/마스크의 수입 검사.
노광전의 Reticle/Mask의 루틴 이물 측정.
Reticle/Mask의 정기적인 이물 측정.
특징
- 최소 검출 감도0.35μm
레이저 산란 방식과 독자적인 신호 처리 방식의 채용에 의해, 최소 0.35μm의 이물의 검출이 가능 합니다. Reticle/Mask 선폭 1.0μm,까지 라인간 1.0μm의 패턴 판별 기능에 의해서, 검출 오차를 최소한으로 억제합니다.
- 각종 스텝퍼 케이스에 대응하는 다단 Sorter。
최대 10단까지 가능한 다단 Sorter는, 각종 스텝퍼 케이스는 물론 SMIF-POD에 대응이 가능 합니다. 여러 메이커나 다른 사이즈의 스텝퍼 케이스와 편성이 가능합니다. - 조작은 간단.DMS로 데이터 관리도 가능
Reticle의 크기, 검사의 형상, 검사 표면의 면적, 레벨 등의 다양한 검사 조건을 설정할 수 있고, 측정 조작은 매우 간단합니다. 또한, 측정 결과는 이물의 크기에 의해 Mapping 표시되어, 검출 조작중에 기판상에서 발견된 이물을 매트릭스로 실시간 표시할 수 있습니다. 검사 결과는 데이터 베이스 서버에 보존되어, DMS(데이터 관리 소프트)에 의해서 데이터 관리, 각종 리포트 출력과 사용자 조건의 설정 등 다채로운 관리가 가능 합니다. LAN 접속에 의한 데이터의 쌍방향 통신도 실시할 수 있습니다.

▲Map화면
* Map 화면에서는 검출한 이물의 Map을 참조하거나 이물을 관찰 할 수 있습니다. 결과 List 화면에서, Map 버튼을 누르면, 이물 Map도 표시됩니다.또, 이물을 지정하면, Map옆에 이물 현미경으로 화면을 표시하는 것도 가능합니다.

▲검사결과1
검사 결과를 보고서로 출력할 수 있습니다. Reference로 등록되어 있는 데이터의 이물 주소와 다른 주소, 검출 개수 판정, 증가 갯수 판정 결과도 출력 가능합니다.

▲검사이력
과거의 검사 결과를 간단하게 볼 수 있습니다. 특정 Reticle의 측정 결과에서 이물의 검출 총수, 검출 비율등의 경력을 그래프 표시하는 것도 가능합니다.

▲검사결과2
검사 결과를 Map으로 출력할 수 있습니다. Map을 확대 표시하면, 확대한 상태로 출력되므로, 특정의 부분을 잘 보이게 출력하는데 편리합니다.
■통신접속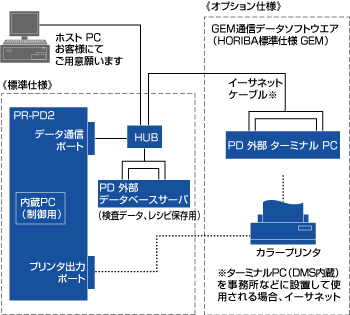
- 상하면 이물관찰기능 。
Reticle/Mask 위쪽에 1개, 아래 쪽에 4개의 현미경 대물렌즈를 탑재하여, 표면은 440배, 아래쪽 검사면은 220배, 440배, 880배, 2200배의 관찰 배율로 전환이 가능합니다. 이것으로, 상하면의 이물을 직접 관찰할 수 있습니다.
- 높은 수준의 오류 검출 방지 기능 。
독자적인 신호 처리 방식을 채용하여, 1.0μm/1.0μmL&S레벨까지 오류 검출 방지가 가능합니다. lowpass filter를 사용한 패턴변별 기능에 의해서, 유사 검출을 최소한으로 억제해 밀집한 패턴의 오류 검출에 대한 대책도 효과적으로 실시할 수 있습니다.
이물의 검출 원리는 레이저 산란 방식을 사용하고 있습니다. 레이저의 빛이 이물에 조사되면 산란되고, 그 산란 강도를 측정하는 것으로써 이물을 검출합니다. Galvano Mirror에 의해 검사면 전체에 걸쳐서 레이저 빛을 주사해, 산란된 빛의 강도를 측정합니다. 레이저빛은 Reticle이나 Mask상의 패턴에 의해서도 산란이 되지만, 이물과 패턴과는 산란되는 빛의 편광 특성이 다름으로, 광학계에 편광 소자를 삽입하여, 양자를 변별 하게 됩니다. 게다가 이물과 패턴과는 신호에 차이가 있는 것에 주목해, 독자적으로 개발한 lowpass filter에 의해 변별율을 향상시켰습니다. 또한, Ar-레이저(488nm)를 채용하여 안정된 가동을 할 수 있습니다. 이러한 기술 개발을 통하여, 첨단 Mask에서 범용 Mask까지 폭넓은 대응이 가능해졌습니다. 。